新製品:SiCウェハ欠陥検査/レビュー装置「SICA88」を発表
2015年09月24日
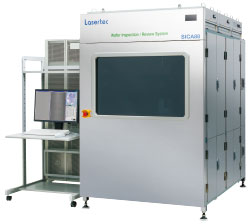
表面検査およびフォトルミネッセンス(PL)検査の両方を備えた検査装置
レーザーテック株式会社は、このほど表面検査およびフォトルミネッセンス(PL)検査の両方を備え、SiCウェハの表面と内部の欠陥を検出、高精度分類まで同時に行えるSiCウェハ欠陥検査/レビュー装置SICA88を製品化いたしました。すでに受注活動を開始し、ローム株式会社様を始めとし、複数社での採用が決定しております。
説明
SiCパワーデバイスはすでにエアコン、太陽光発電システム、鉄道車両などに使用されており、今後電気自動車などへの搭載が期待され、市場を着実に拡げております。しかし、SiCパワーデバイスは、その製造の難しさゆえに、いまだ生産工程において結晶欠陥などの様々な問題が発生しており、品質の確保とコストの両面で大きな課題を抱えています。ウェハメーカーではウェハの品質向上と品質管理が必要とされ、デバイスメーカーにおいてはデバイスの歩留り向上と、さらなる低コスト化が求められています。
SICAはこのようなニーズにお応えした検査装置で、2009年に研究開発用のSICA61、2011年に量産用のSICA6Xを発売以来、高い検出感度と高精度な欠陥分類が評価され、業界標準機として多くのお客さまにご採用いただいている製品です。
このたび新たに開発したSICA88は従来からのコンフォーカルDIC光学系による表面検査とPL検査を1台に搭載した新しいプラットフォームの検査装置です。表面検査ではウェハ表面のスクラッチやエピ欠陥を、PL検査ではエピ膜内部の基底面内転位(BPD)や積層欠陥(SF)を同時に検出・高精度分類・判定することで、デバイスの不良原因となる欠陥の発見および解析に役立ちます。また、スループットは既存機種であるSICA6Xの2倍に高めました。さらに、BPD検査を行う場合もスループットを落とさず検査ができます。本装置はウェハプロセス、Epiプロセス、デバイスプロセスの各プロセスモニタとして、欠陥発生の原因追及に最適であり、さらにウェハのグレーディング※1によるプロセスコストの削減とデバイスの歩留り向上を可能にいたします。
レーザーテックは、これからも欠陥検査技術の開発に一層の力を注ぎ、パワーデバイスの品質および生産性の向上に貢献してまいります。
- ※1ウェハの選別と、ランク付け
特長
- 表面欠陥と同時にエピ膜付きウェハ内部の基底面内転位(BPD)、積層欠陥(SF)など結晶欠陥を高感度に検出
- 欠陥の高解像度レビュー画像の取得と同時に高精度自動欠陥分類(ADC)によって、各種欠陥を詳細分類。高解像度の欠陥画像を取得できるため、顕微鏡での再観察不要
用途
- SiCウェハ、エピウェハの出荷・受入検査
- SiCエピタキシャル成長プロセスの管理
- SiC研磨プロセスの管理
- SiCデバイス製造プロセスの管理
